Le document traite des semi-conducteurs à l'équilibre, leur dopage, la structure en bandes d'énergie, et la densité de porteurs, en expliquant les concepts clés tels que la conduction bipolaire et la position du niveau de Fermi. Il aborde également les semi-conducteurs hors équilibre, les processus de génération et recombinaison, et les courants dans ces matériaux. Des équations mathématiques et des modèles sont présentés pour décrire le comportement des semi-conducteurs en fonction de différentes conditions de température et de dopage.













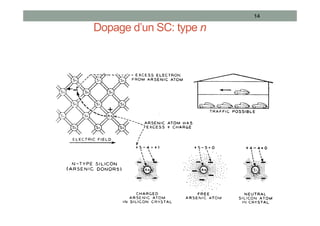
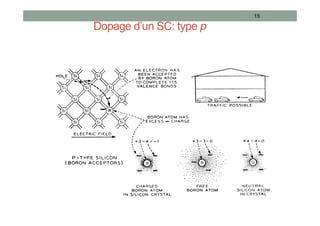
















![Phénomènes de Génération - Recombinaison
• Loi d’action de masse:
• À l’équilibre thermodynamique:
• Hors équilibre: apparition de phénomènes de Génération -
Recombinaison
• création ou recombinaison de porteurs :
Unité [g]=[r]=s-1cm-3
• Taux net de recombinaison:
32
r
g
r
g
g
r
g th
'
'
' avec
th
g
r
r
'
externe interne
2
i
n
np ](https://image.slidesharecdn.com/1-1-211026184828/85/1-1-32-320.jpg)














![Courants dans les SC
• Courant de diffusion:
• Origine: gradient de concentration
• Diffusion depuis la région de forte concentration vers la région de
moindre [].
• 1° loi de Fick:
47
dx
dp
D
p
dx
dn
D
n
p
x
D
n
x
D
nb d’e- qui diffusent par unité de
temps et de volume (flux)
nb de h+ qui diffusent par unité de
temps et de volume (flux)](https://image.slidesharecdn.com/1-1-211026184828/85/1-1-47-320.jpg)
![Courants dans les SC
• Courant de diffusion: somme des deux contributions
(électrons et trous):
• Constante ou coefficient de diffusion
[ ]=cm2/s.
48
dx
dp
eD
dx
dn
eD
p
n
e
J p
n
x
D
x
D
diff
)
(
p
n
D ,](https://image.slidesharecdn.com/1-1-211026184828/85/1-1-48-320.jpg)







